京大推進研
| 25行: | 25行: | ||
|- | |- | ||
| <h3>Si エッチングのモデリング・シミュレーション</h3> | | <h3>Si エッチングのモデリング・シミュレーション</h3> | ||
| − | 原子スケールにおけるプラズマ・Si 表面相互反応の理解のため、当研究室では独自に原子スケールセルモデル(Atomic-Scale Cellular Model:ASCeM)を開発しています。本モデルでは、被エッチング表面を、基板 Si 原子1個を中央に含む矩形の微小セルに分割するとともに、パターン内(Vacuum)も同じ大きさの矩形セルに分割して、表面/界面移動を取り扱います。粒子輸送、表面反応過程にはモンテカルロ法を用い、イオンの散乱や内部への侵入はでは、入射イオンと基板原子との間の二体ポテンシャルにもとづき、入射イオンの基板原子による古典的な弾性衝突過程を連続的に計算し、表面反射や内部への侵入を表現しています。Cl<sub>2</sub> プラズマによる Si エッチングで特徴的なマイクロトレンチや RIE ラグ・逆 RIE | + | 原子スケールにおけるプラズマ・Si 表面相互反応の理解のため、当研究室では独自に原子スケールセルモデル(Atomic-Scale Cellular Model:ASCeM)を開発しています。本モデルでは、被エッチング表面を、基板 Si 原子1個を中央に含む矩形の微小セルに分割するとともに、パターン内(Vacuum)も同じ大きさの矩形セルに分割して、表面/界面移動を取り扱います。粒子輸送、表面反応過程にはモンテカルロ法を用い、イオンの散乱や内部への侵入はでは、入射イオンと基板原子との間の二体ポテンシャルにもとづき、入射イオンの基板原子による古典的な弾性衝突過程を連続的に計算し、表面反射や内部への侵入を表現しています。Cl<sub>2</sub> プラズマによる Si エッチングで特徴的なマイクロトレンチや RIE ラグ・逆 RIE ラグ等の特異形状の形成には、中性活性種のフラックス量と入射イオンフラックス量が大きく関係していることを突き止めました。本モデルを使った解析により、側壁隣接したパターン底面では、パターン側壁でのイオン散乱により、入射イオンフラックスが増大し、マイクロトレンチが形成され易くなる一方で、中性活性種が十分存在する場合、イオンアシスト反応によるエッチング速度が増大し、マイクロトレンチ形成と逆 RIE ラグに至ることを示唆しています。 |
* Y. Osano and K. Ono, J. Vac. Sci. Technol. B '''26'''(4) (Aug 2008) 1425-1439. http://dx.doi.org/10.1116/1.2958240 | * Y. Osano and K. Ono, J. Vac. Sci. Technol. B '''26'''(4) (Aug 2008) 1425-1439. http://dx.doi.org/10.1116/1.2958240 | ||
| 39行: | 39行: | ||
|- | |- | ||
| <h3>O<sub>2</sub> 添加時における残渣発現メカニズム解明</h3> | | <h3>O<sub>2</sub> 添加時における残渣発現メカニズム解明</h3> | ||
| − | ASCeM | + | ASCeM は、従来のシミュレーションモデルでは再現しにくい鋭い残渣形状(剣山状の形状)や nm スケールの表面ラフネスの形成メカニズムを詳細に解析することが可能です。右図は、酸素を付加した条件において、粒子輸送における幾何学的シャドーイング効果により、表面ラフネスがより発達する様子を示しています。酸素流入が増えると、パターン底面の局所表面酸化により、残渣(マイクロピラー)が顕著に発現します。各残渣の上部は(凸部)の表面には O 原子が多く存在し、イオン入射によるエッチング/スパッタリングが抑制されるが、残渣の下部(凹部)の表面では、中性シャドーイング効果に起因して O 原子が少なく、イオン入射によるエッチング/スパッタリングが進行して残渣形状が発達することがわかりました。 |
* K. Ono, et al., Thin Solid Films '''518'''(13) (2010) 3461-3468. [[doi:10.1016/j.tsf.2009.11.030]] | * K. Ono, et al., Thin Solid Films '''518'''(13) (2010) 3461-3468. [[doi:10.1016/j.tsf.2009.11.030]] | ||
| 53行: | 53行: | ||
|- | |- | ||
| <h3>3次元原子スケールセルモデル (ASCeM-3D)</h3> | | <h3>3次元原子スケールセルモデル (ASCeM-3D)</h3> | ||
| − | 原子スケールにおけるプラズマ・Si 表面相互反応の理解のため、これまでの | + | 原子スケールにおけるプラズマ・Si 表面相互反応の理解のため、これまでの 2次元モデルを改良して、奥行き方向の形状解析を可能とする 3次元原子スケールセルモデル(Three-Dimensional Atomic-Scale Cellular Model:ASCeM-3D)を新たに開発し、Cl 系プラズマによるSi エッチング 3次元形状進展シミュレーターの高精度化を図っています。ASCeM-3D はセル・リムーバル法を使った当研究室独自のモデルであり、従来のシミュレーターでは再現しにくい残渣形状や nm スケールの微小な表面ラフネスの形成メカニズムを詳細に解析することが可能です。 |
* H. Tsuda, et al., Jpn. J. Appl. Phys. (2011) in press. | * H. Tsuda, et al., Jpn. J. Appl. Phys. (2011) in press. | ||
2011年7月21日 (木) 17:24時点における版
目次 |
Si エッチングのモデリング・シミュレーション原子スケールにおけるプラズマ・Si 表面相互反応の理解のため、当研究室では独自に原子スケールセルモデル(Atomic-Scale Cellular Model:ASCeM)を開発しています。本モデルでは、被エッチング表面を、基板 Si 原子1個を中央に含む矩形の微小セルに分割するとともに、パターン内(Vacuum)も同じ大きさの矩形セルに分割して、表面/界面移動を取り扱います。粒子輸送、表面反応過程にはモンテカルロ法を用い、イオンの散乱や内部への侵入はでは、入射イオンと基板原子との間の二体ポテンシャルにもとづき、入射イオンの基板原子による古典的な弾性衝突過程を連続的に計算し、表面反射や内部への侵入を表現しています。Cl2 プラズマによる Si エッチングで特徴的なマイクロトレンチや RIE ラグ・逆 RIE ラグ等の特異形状の形成には、中性活性種のフラックス量と入射イオンフラックス量が大きく関係していることを突き止めました。本モデルを使った解析により、側壁隣接したパターン底面では、パターン側壁でのイオン散乱により、入射イオンフラックスが増大し、マイクロトレンチが形成され易くなる一方で、中性活性種が十分存在する場合、イオンアシスト反応によるエッチング速度が増大し、マイクロトレンチ形成と逆 RIE ラグに至ることを示唆しています。
|
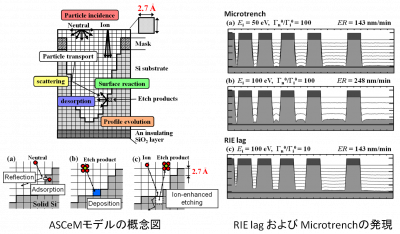
|
O2 添加時における残渣発現メカニズム解明ASCeM は、従来のシミュレーションモデルでは再現しにくい鋭い残渣形状(剣山状の形状)や nm スケールの表面ラフネスの形成メカニズムを詳細に解析することが可能です。右図は、酸素を付加した条件において、粒子輸送における幾何学的シャドーイング効果により、表面ラフネスがより発達する様子を示しています。酸素流入が増えると、パターン底面の局所表面酸化により、残渣(マイクロピラー)が顕著に発現します。各残渣の上部は(凸部)の表面には O 原子が多く存在し、イオン入射によるエッチング/スパッタリングが抑制されるが、残渣の下部(凹部)の表面では、中性シャドーイング効果に起因して O 原子が少なく、イオン入射によるエッチング/スパッタリングが進行して残渣形状が発達することがわかりました。
|

|
大規模スケール分子動力学 (MD) 法分子動力学(Molecular Dynamics)法を駆使し、Cl2/O2 混合プラズマによる Si エッチングにおける表面反応を追跡しています。これまでの研究により、O 原子は Si 基板原子と強く結びつき、また Si 表面上に局在する傾向があり、そのことが、微小な表面ラフネス形成を引き起こす要因となることを突き止めました。 この微小な表面ラフネスは、さらに大きなスケール(ナノ~マイクロオーダー)のラフネス形成を誘発すると考えられ、今後のデバイス開発においては、こうした微小な表面ラフネスの正確な制御が強く要求されます。
|

|